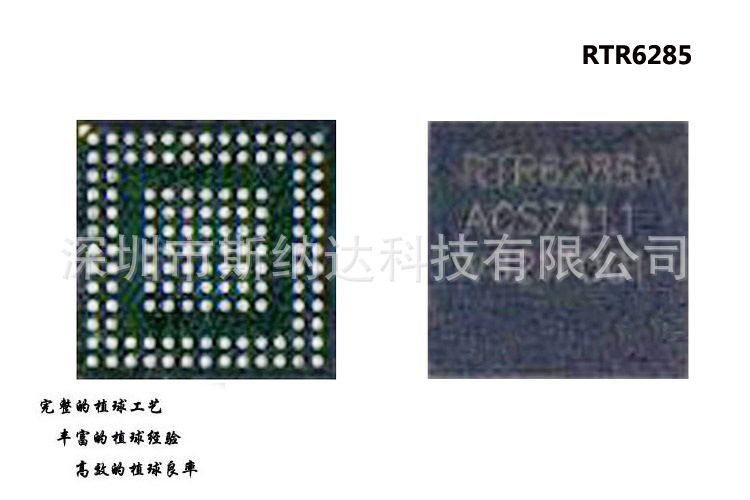
斯纳达科技拥有完整的植球工艺,特别是对高通(m)系列PAD内凹3D封装芯片植球有独到工艺,地解决了小间距POP芯片植球难题,焊盘残锡处理技术已经达到国内外先进水平。
POP植球,修旧如新!
我们的植球工艺,ESD防护,IC烘烤,ROHS等各项指标均达到一些大公司BGA返修的基本要求;
目前我们的主要客户有:东莞柏能(TI OMAP4430,4460,4470); 珠海伟创力(MSM8655); 华为(MSM8655); 高通(m); 富士康;惠州三星电子;TCL;金立手机等。
BGA植球优势:
1、完善的除锡工艺,确保每个焊点上的锡点均匀;
2、8个温区的回流焊焊接;
3、自主研发生产测试设备,先测试为良品后植球
4、自主开发各类BGA植球辅助治具,如双螺植球治具已经申请了国家专利(专利号:201120194711.9);
5、POP植球一直是在为一些国际化的大公司服务,按高标准严格执行各项工艺,各项指标都符合高通原厂及各大厂的要求,如ESD/RHOS等;
6、技术团队从业十多年,有非常丰富的经验。
我们的指导思想是:苛求细节,追求!!
