
1)已知自己拥有什么样的材料,但是想要更多关于具体性能的信息,比如界面锐度、剖面分布、形态、晶体结构、厚度、应力以及质量。
2)您有对之不是完全了解的材料,想找出有关它的成份、沾污、残留物、界面层、杂质等。
扫描探针显微镜/原子力显微镜(AFM)
扫描探针显微镜,俗称原子力显微镜(AFM),提供原子或接近原子分辨率的表面图形,是测定埃尺度表面粗糙样本的理想技术。除显示表面图像, AFM还可以提供特征尺寸定量测量, 例如步进高度测量;其他样本特性,如为确定载体和掺杂剂的分布和测量电容。
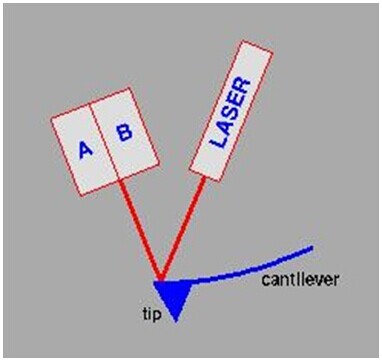
AFM测试原理图
- 应用范围
- 主要优点
- 技术参数
AFM应用:
三维表面结构图像,包含表面粗糙度、微粒尺寸、步进高度、倾斜度
加工前后晶圆上(二氧化硅、砷化镓、锗化硅等)评估
测定接触镜片、导管、支架和其他生物医药表面的加工效果(如等离子处理)
测定表面粗糙度对粘合和其他工艺的影响
测定有图案晶圆的沟壁形状/洁净度
测定形态/结构是否为表面几何形状的来源
俄歇电子能谱 (AES, Auger)
俄歇电子能谱(AES、Auger)是一种利用高能电子束为激发源的表面分析技术. AES分析区域受激原子发射出具有元素特征的俄歇电子。
AES电子束可以扫描一块或大或小的表面. 它也可以直接聚焦在小块表面形貌上(半导体产业经常要求这样)。聚焦电子束斑到10nm或更小的直径使得AES成为小表面形貌元素分析的非常有用的工具。此外,它能够在可调整的表面区域内栅蔽电子束从而控制分析区域的尺寸。 当用来与溅射离子源的结合时, AES能胜任大、小面积的深度剖面。 当与聚焦离子束(FIB)一起使用时,它对于截面分析是很有用的。
|
|
AES点扫描成分分析图谱 | AES深度溅射氧化铝厚度测量 |
|
|
AES线扫描成分分析图谱 | AES面扫描成分分析图谱 |
|
|
AES分析表面异物 | |
应用范围:
缺陷分析
颗粒分析
表面分析
小面积深度剖面
工艺控制
薄膜成分分析
AES优点:
小面积分析(30纳米)
良好的表面灵敏度
良好的深度分辨率
二次离子质谱(SIMS)
二次离子质谱分析技术(SIMS)是用来检测低浓度掺杂剂和杂质的分析技术。 它可以提供范围在数埃至数十微米内的元素深度分布。SIMS是通过一束初级离子来溅射样品表面。二次离子在溅射过程中形成并被质谱仪提取分析. 这些二次离子的浓度范围可以高达被分析物本体水平或低于ppm痕量级以下。
SIMS可帮助客户解决产品研发、质量控制、 失效分析、故障排除和工艺监测中的问题。
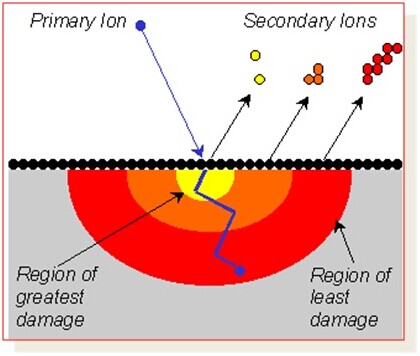
二次离子激发示意图
扫描电子显微镜/X射线能谱仪(SEM/EDS)
扫描电子显微镜/X射线能谱仪(SEM/EDS)是依据电子与物质的相互作用。当一束高能的入射电子轰击物质表面时,被激发的区域将产生二次电子、俄歇电子、特征x射线和连续谱X射线、背散射电子、透射电子,以及在可见、紫外、红外光区域产生的电磁辐射。原则上讲,利用电子和物质的相互作用,可以获取被测样品本身的各种物理、化学性质的信息,如形貌、组成、晶体结构、电子结构和内部电场或磁场等等。SEM/EDS正是根据上述不同信息产生的机理,对二次电子、背散射电子的采集,可得到有关物质微观形貌的信息,对x射线的采集,可得到物质化学成分的信息。
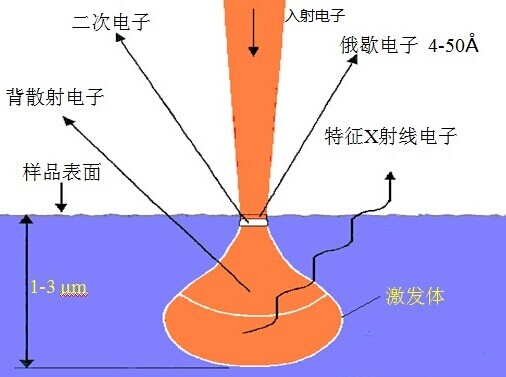
电子束激发样品表面示意图
- 应用范围
- 主要优点
主要特点:
1.样品制备简单,测试周期短;
2.景深大,有很强的立体感,适于观察像断口那样的粗糙表面;
3.可进行材料表面组织的定性、半定量分析;
4.既保证高电压下的高分辨率,也可提供低电压下高质量的图像;